
技术文章
TECHNICAL ARTICLES 更新时间:2026-02-15
更新时间:2026-02-15 点击次数:165
点击次数:165
在半导体器件制造中,氮化硅(Si₃N₄)薄膜凭借zhuo越的化学惰性、机械硬度和扩散阻挡特性,成为器件表面钝化、杂质扩散掩膜的核心材料。由 LPCVD(低压化学气相沉积)、PECVD(等离子体增强化学气相沉积)制备的氮化硅膜为半透明 / 透明硬质薄膜,厚度区间精准控制在 50nm~2μm,其厚度精度直接决定钝化层的防护效果和掩膜层的工艺一致性,是影响半导体器件良率和性能的关键因素。针对氮化硅钝化 / 掩膜层测厚的纳米级精度要求、产线复杂环境适配性以及在线高速检测需求,无锡泓川科技推出的LT-R 系列反射膜厚仪凭借白光干涉核心技术、超高精度测量性能、强抗干扰系统设计,成为 LPCVD/PECVD 氮化硅膜厚测量的专属解决方案,wan美适配半导体行业的严苛工艺标准。

氮化硅薄膜在半导体器件中的应用场景决定了其测厚工作需突破多重技术难点,而 LPCVD/PECVD 的制备工艺特性进一步提升了测量要求,传统测厚手段已难以满足产业升级需求,主要痛点集中在以下方面:
纳米级精准测量要求严苛:氮化硅钝化层需有效阻挡钠离子、钾离子等杂质扩散,掩膜层需保证杂质扩散的工艺精度,膜厚偏差若超出 ±3%(成熟制程标准),将直接导致器件性能漂移甚至失效。50nm~2μm 的半透明 / 透明薄膜特性,要求测厚设备兼具超高重复精度和准确度,且能识别薄膜 Si/N 比偏离、氮氧化硅形成带来的光学特性变化。
硬质薄膜与工艺适配性难题:LPCVD 氮化硅膜致密、硬度高,PECVD 氮化硅膜应力可调但微观结构复杂,传统接触式测厚设备易造成薄膜表面划伤,非接触式设备则常因光学模型不匹配导致测量误差。同时,氮化硅膜常为单层或与二氧化硅形成多层膜系,要求测厚设备具备多层透明膜测量能力。
半导体产线环境干扰大:半导体制造车间存在机械振动、粉尘、温度波动等干扰因素,而测厚工作需在产线现场完成,设备若抗干扰能力不足,将出现测量数据漂移,无法保证检测结果的稳定性。
在线高速检测的产线需求:半导体量产环节对检测效率要求ji高,离线抽样检测已无法满足工艺实时监控需求,需测厚设备具备高采样速度,实现膜厚的在线实时检测,及时反馈工艺偏差。
产线紧凑布局的安装要求:半导体晶圆制造、封装产线的设备布局紧凑,测厚探头需小巧轻便、安装距离灵活,避免对现有产线进行大规模改造,同时满足不同检测点位的测量角度需求。
泓川 LT-R 系列反射膜厚仪基于白光干涉测厚原理设计,wan美契合氮化硅半透明 / 透明硬质薄膜的光学特性,是针对微纳级薄膜测量的非接触式技术方案。其核心原理为:宽谱白光入射到氮化硅薄膜后,薄膜上表面与基底界面的反射光发生干涉,形成与薄膜厚度、光学常数直接相关的反射光谱,设备通过高效模型拟合分析算法,从反射光谱中精准解析出氮化硅膜厚,同时可同步获取折射率、消光系数等关键参数。

高强度宽谱组合光源:采用氘灯(190-400nm)+ 卤素灯(350-2500nm)的组合光源设计,光谱覆盖紫外、可见光到近红外全范围,针对氮化硅在紫外波段的特征反射特性和近红外波段的低吸收特性,大幅提升测量的灵敏度和稳定性,即使面对 Si/N 比偏离、氮氧化硅形成的复杂氮化硅膜,也能捕捉清晰的干涉光谱。
氮化硅专属模型拟合算法:在通用模型拟合算法基础上,融入泓川科技专有的氮化硅扩散模型,充分考虑氮化硅薄膜的化学计量比变化、氧渗入对光学特性的影响,实现对 LPCVD/PECVD 氮化硅膜厚的精准解析,同时支持自定义膜结构测量,可适配氮化硅与二氧化硅形成的多层膜系检测。
此外,设备采用 6 个照明光纤 + 1 个反射光纤的探头设计,保证入射光的均匀性和反射光的收集效率,即使在小光斑测量场景下,也能获得稳定的干涉信号,为氮化硅膜厚的精准测量奠定基础。
结合半导体氮化硅钝化 / 掩膜层的测厚需求,泓川 LT-R 系列反射膜厚仪从精度、抗干扰、效率、适配性等维度打造了全fang位的技术优势,成为产线现场测厚的理想选择:
LT-R 系列的重复精度达 0.05nm,准确度 <±1nm(或 ±0.3%,取较大值),远超半导体成熟制程对氮化硅膜厚 ±3% 的偏差要求。设备测厚范围为 20nm~50μm,wan全覆盖氮化硅钝化 / 掩膜层 50nm~2μm 的厚度区间,无论是超薄 PECVD 钝化层还是较厚的 LPCVD 掩膜层,均能实现精准测量。实际应用中,对 200nm 氮化硅薄膜的测量误差可控制在 ±1nm 内,折射率测量精度达 ±0.01,充分满足半导体行业对膜厚及光学参数的检测要求。
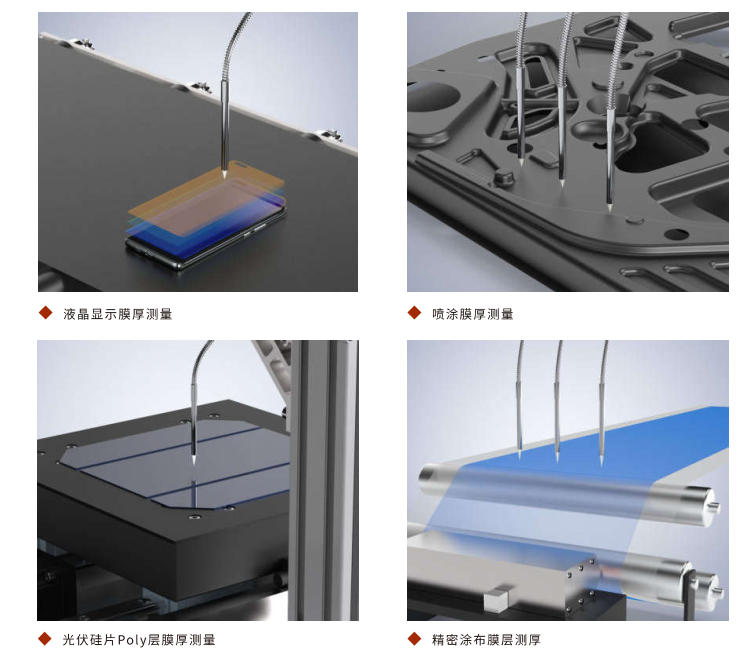
为解决产线振动、粉尘等干扰问题,LT-R 系列从硬件到软件进行了全fang位的抗干扰优化:硬件上采用高灵敏度、高信噪比的光学元器件,大幅降低噪声干扰;软件上搭载独特的模型多参数反演算法,有效抵消外部扰动对测量结果的影响;同时创新的光学系统设计,保证设备在物理受限、环境恶劣的产线现场仍能稳定工作。设备外壳防护等级达 IP40,可有效防止粉尘、碎屑进入,进一步提升了产线环境的适配性。
LT-R 系列的采样频率zui高可达 100Hz(视求解参数复杂度而定),单点测量速度快,可实现半导体产线的在线实时检测,替代传统的离线抽样检测。在 LPCVD/PECVD 氮化硅沉积环节,设备可实时监控晶圆表面的膜厚分布,及时反馈沉积工艺的均匀性偏差,帮助工艺工程师快速调整工艺参数,避免批量不良品的产生,大幅提升产线生产效率。
针对 LPCVD/PECVD 氮化硅的硬质薄膜特性,LT-R 系列采用非接触式光学测量方式,全程无机械接触,避免对氮化硅膜表面造成划伤或污染,同时设备专门优化了硬薄膜的光学解析模型,可精准识别硬质薄膜与基底的界面反射信号,解决了传统设备对硬薄膜测量误差大的问题。此外,设备还支持多层透明膜测量,可适配氮化硅 - 二氧化硅多层膜系的测厚需求,满足半导体器件多层介质膜的检测场景。
LT-R 系列提供LTP-T10-UV-VIS和LTVP-TVF两款适配探头,针对产线不同检测点位进行了个性化设计:LTP-T10-UV-VIS 探头外径仅 Φ6.35mm,重量 190g,建议安装距离 5~10mm,小巧轻便,适合产线狭小空间的安装;LTVP-TVF 探头支持径向 / 轴向出光,安装侧面出光附加镜时工作距离 34.5mm±2mm,轴向出光时 55mm±2mm,可适配不同测量角度需求,附加镜仅 49g,拆装灵活。两款探头的测量角度分别为 ±10° 和 ±5°,可根据晶圆表面的检测需求灵活选择,无需对现有产线进行大规模改造,降低设备集成成本。
LT-R 系列搭载WLIStudio 上位机软件,内置暗校准、反射率归一化、光源特性补偿等功能,可对氮化硅膜厚测量数据进行实时分析、存储和可视化展示,同时生成检测报告,满足半导体行业的质量追溯需求。软件还支持膜厚均匀性分析,可对晶圆多点测量数据进行统计,计算片内均匀性(WIW),为工艺优化提供数据支撑。此外,设备提供WLI-SDK 二次开发包,可无缝对接半导体产线的 MES 系统,实现膜厚数据的自动化上传和工艺联动控制,契合半导体行业的智能制造趋势。

泓川 LT-R 系列反射膜厚仪的各项技术参数均围绕半导体氮化硅钝化 / 掩膜层的测厚需求设计,从测量范围、环境耐性到供电标准,全fang位适配半导体产线的应用场景,核心参数匹配度如下表所示:
| 氮化硅测厚核心需求 | LT-R 系列对应参数 | 匹配优势 |
|---|---|---|
| 厚度 50nm~2μm | 测厚范围 20nm~50μm(折射率 1.5 时) | wan全覆盖目标厚度区间,兼顾超薄与常规厚度测量 |
| 纳米级精度要求 | 重复精度 0.05nm,准确度 <±1nm/±0.3% | 满足半导体成熟制程 ±3% 偏差标准,远超行业要求 |
| 在线高速检测 | 采样频率 Max.100Hz | 实现实时工艺监控,及时反馈偏差 |
| 产线温度波动 | 工作温度 - 10~+40℃ | 适配半导体车间温度环境,无需额外恒温措施 |
| 产线紧凑布局 | 探头 Φ6.35mm/Φ20mm,重量 190g/108g | 小巧轻便,狭小空间可安装 |
| 多点位测量角度 | 测量角度 ±10°/±5° | 适配晶圆不同位置的检测需求 |
| 工业现场供电 | 电源电压 220V±20V 50Hz AC | 符合工业供电标准,直接集成产线 |
| 数据智能化管理 | WLIStudio 软件 + WLI-SDK 开发包 | 支持数据存储、追溯与 MES 系统对 接 |
此外,设备zui大功率仅 50W,能耗低,控制器重量 5000g,便于产线移动和布局调整;相对湿度适应范围 20%~85% RH(无冷凝),可适配半导体车间的湿度环境,进一步提升了设备的现场适用性。
提升器件良率,保障工艺一致性:0.05nm 的超高重复精度让氮化硅膜厚的均匀性检测更精准,有效避免因膜厚偏差导致的钝化层防护失效、掩膜层杂质扩散偏差等问题,某晶圆制造企业引入该设备后,氮化硅膜相关工艺的器件良率提升了 3% 以上。
降低产线成本,提高生产效率:zui高 100Hz 的采样速度实现了氮化硅膜厚的在线实时检测,替代了传统的离线抽样检测,减少了工艺等待时间和离线检测的人力成本,同时及时的工艺偏差反馈,降低了批量不良品的产生概率,大幅节约了生产成本。
简化产线集成,降低改造成本:小巧易安装的探头设计和灵活的安装距离,让设备可直接集成到 LPCVD/PECVD 沉积设备旁,无需对现有产线进行大规模改造,设备集成周期缩短至 1-2 天,大幅降低了产线升级的时间和资金成本。
实现数据化管理,助力工艺优化:WLIStudio 软件的数据分析和可视化功能,可对氮化硅膜厚的测量数据进行统计分析,为工艺工程师提供膜厚分布、均匀性等关键数据,帮助工程师优化 LPCVD/PECVD 的沉积温度、气体比例等工艺参数,进一步提升氮化硅膜的制备质量。
无损检测保护薄膜,提升产品可靠性:非接触式的测量方式避免了对氮化硅硬质薄膜的表面损伤,保证了薄膜的完整性和防护效果,同时精准的膜厚测量让氮化硅膜的性能更稳定,提升了半导体器件的长期工作可靠性。
无锡泓川科技作为专业的薄膜测量设备制造商,深耕光学测厚领域多年,凭借核心的白光干涉技术、自主研发的模型拟合算法和定制化的行业解决方案,成为泛半导体领域膜厚测量的lin军企业。除氮化硅钝化 / 掩膜层测厚外,LT-R 系列反射膜厚仪还成功应用于液晶显示膜厚测量、光伏硅片 Poly 层膜厚测量、精密涂布膜层测厚等场景,技术实力和产品可靠性得到了市场的充分验证。
针对半导体行业的个性化需求,泓川科技可提供定制化的测厚解决方案,根据客户的氮化硅制备工艺、产线布局、检测需求,优化探头设计和光学模型,同时提供专业的安装调试和技术培训服务,确保设备快速落地使用。未来,泓川科技将继续聚焦半导体行业的微纳级薄膜测量需求,持续迭代技术,推出更贴合行业发展的测厚设备,为半导体产业的工艺升级和良率提升提供核心支撑。
氮化硅钝化 / 掩膜层的厚度精度是半导体器件制造的关键工艺指标,直接决定了器件的性能和良率。泓川 LT-R 系列反射膜厚仪以白光干涉为核心,凭借 0.05nm 的超高重复精度、强抗干扰的系统设计、100Hz 的高速采样和小巧易安装的探头设计,wan美解决了 LPCVD/PECVD 氮化硅半透明 / 透明硬质薄膜的测厚痛点,实现了纳米级精准、在线实时、无损稳定的膜厚测量。作为半导体氮化硅测厚的专属解决方案,LT-R 系列反射膜厚仪不仅为半导体企业带来了生产效率和产品良率的双重提升,更以数字化、智能化的检测能力,契合了半导体行业的智能制造趋势,成为半导体器件制造中氮化硅膜厚测量的优选设备。
公司邮箱: qinyuankang@163.com
服务热线:
公司地址: 无锡市新吴区天山路8号
Copyright © 2026 无锡泓川科技有限公司 All Rights Reserved
备案号:苏ICP备16036995号-3
技术支持:化工仪器网 管理登录 sitemap.xml
